
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
روشهای اصلی جداسازی
با پیشرفت پردازش نیمه هادی و افزایش تقاضا برای قطعات الکترونیکی، استفاده از ویفرهای بسیار نازک (ضخامت کمتر از 100 میکرومتر) به طور فزاینده ای حیاتی شده است. با این حال، با کاهش مداوم ضخامت ویفر، ویفرها در طی فرآیندهای بعدی مانند سنگ زنی، اچ کردن، و فلزی شدن بسیار آسیب پذیر هستند.
فن آوری های اتصال موقت و جداسازی معمولاً برای تضمین عملکرد پایدار و بازده تولید دستگاه های نیمه هادی استفاده می شود. ویفر فوقالعاده نازک به طور موقت روی یک بستر حامل سفت و سخت ثابت میشود و پس از پردازش پشت، این دو از هم جدا میشوند. این فرآیند جداسازی به عنوان جداسازی شناخته میشود که عمدتاً شامل جداسازی حرارتی، جداسازی لیزری، جداسازی باند شیمیایی و جداسازی مکانیکی است.
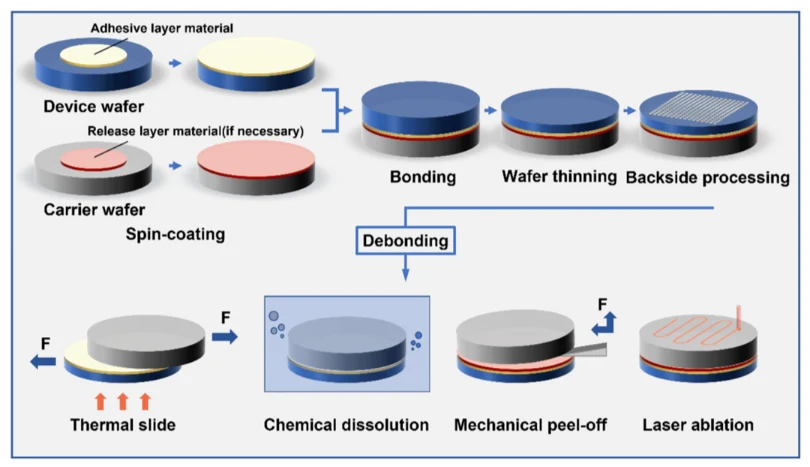
جداسازی حرارتی
جداسازی حرارتی روشی است که ویفرهای فوق نازک را از بسترهای حامل با حرارت دادن جدا می کند تا چسب باندینگ نرم و تجزیه شود و در نتیجه چسبندگی خود را از دست بدهد. عمدتاً به جداسازی اسلاید حرارتی و جداسازی تجزیه حرارتی تقسیم می شود.
جداسازی اسلاید حرارتی معمولاً شامل حرارت دادن ویفرهای چسبانده شده تا دمای نرم شدن آنها است که تقریباً از 190 درجه سانتیگراد تا 220 درجه سانتیگراد متغیر است. در این دما، چسب باندینگ چسبندگی خود را از دست میدهد و ویفرهای بسیار نازک را میتوان به آرامی تحت فشار قرار داد یا از زیر لایههای حامل توسط نیروی برشی اعمال شده توسط دستگاههایی مانند جدا کرد.چاک های خلاءبرای رسیدن به جدایی صاف در حالی که در جدا کردن باند تجزیه حرارتی، ویفرهای باند شده تا دمای بالاتر گرم می شوند و باعث تجزیه شیمیایی (بریدگی زنجیره مولکولی) چسب و از دست دادن کامل چسبندگی آن می شود. در نتیجه، ویفرهای چسبانده شده را می توان به طور طبیعی و بدون هیچ نیروی مکانیکی جدا کرد.
جداسازی لیزری
باندینگ لیزری یک روش جداسازی باندینگ است که از تابش لیزر بر روی لایه چسب ویفرهای باند شده استفاده می کند. لایه چسب انرژی لیزر را جذب کرده و گرما تولید می کند و در نتیجه تحت یک واکنش فوتولیتیک قرار می گیرد. این روش جداسازی ویفرهای بسیار نازک از بسترهای حامل در دمای اتاق یا دمای نسبتاً پایین را امکان پذیر می کند.
با این حال، یک پیش نیاز اساسی برای جداسازی لیزر این است که بستر حامل باید نسبت به طول موج لیزر مورد استفاده شفاف باشد. به این ترتیب، انرژی لیزر می تواند با موفقیت به بستر حامل نفوذ کند و به طور موثر توسط مواد لایه پیوند جذب شود. به همین دلیل، انتخاب طول موج لیزر بسیار مهم است. طول موج های معمولی شامل 248 نانومتر و 365 نانومتر است که باید با ویژگی های جذب نوری ماده پیوند مطابقت داشته باشد.
جداسازی شیمیایی
جداسازی شیمیایی با حل کردن لایه چسبنده با یک حلال شیمیایی اختصاصی، به جداسازی ویفرهای پیوندی دست می یابد. این فرآیند مستلزم نفوذ مولکول های حلال به لایه چسب برای ایجاد تورم، بریدگی زنجیره و در نهایت انحلال است که به ویفرهای فوق نازک و بسترهای حامل اجازه می دهد تا به طور طبیعی جدا شوند. از این رو، هیچ تجهیزات گرمایش اضافی یا نیروی مکانیکی که توسط چاکهای خلاء ارائه میشود مورد نیاز نیست، جداسازی شیمیایی کمترین تنش را روی ویفرها ایجاد میکند.
در این روش، ویفرهای حامل اغلب از قبل سوراخ می شوند تا حلال به طور کامل با لایه پیوند تماس پیدا کند و حل شود. ضخامت چسب بر راندمان و یکنواختی نفوذ و انحلال حلال تأثیر می گذارد. چسبهای باندینگ محلول عمدتاً مواد ترموپلاستیک یا اصلاحشده مبتنی بر پلیآمید هستند که معمولاً با پوشش اسپین اعمال میشوند.
جداسازی مکانیکی
جداسازی مکانیکی ویفرهای بسیار نازک را از بسترهای حامل موقت منحصراً با اعمال نیروی لایهبرداری مکانیکی کنترلشده، بدون گرما، حلالهای شیمیایی یا لیزر جدا میکند. این فرآیند شبیه به جدا کردن نوار است، جایی که ویفر به آرامی از طریق عملیات مکانیکی دقیق "بلند می شود".
Semicorex کیفیت بالایی را ارائه می دهدچاک های جداکننده سرامیکی متخلخل SIC. اگر سؤالی دارید یا نیاز به جزئیات بیشتری دارید، لطفاً در تماس با ما دریغ نکنید.
تلفن تماس 86-13567891907
ایمیل: sales@semicorex.com




