
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
فرآیندهای LPCVD چیست؟
فرآیندهای رسوب بخار شیمیایی کم فشار (LPCVD) تکنیک های CVD هستند که مواد لایه نازک را بر روی سطوح ویفر در محیط های کم فشار رسوب می دهند. فرآیندهای LPCVD به طور گسترده در فنآوریهای رسوبگذاری مواد برای ساخت نیمهرسانا، الکترونیک نوری و سلولهای خورشیدی لایه نازک استفاده میشوند.
فرآیندهای واکنش LPCVD معمولاً در یک محفظه واکنش کم فشار، معمولاً در فشار 1-10 Torr انجام می شود. پس از اینکه ویفر تا محدوده دمایی مناسب برای واکنش رسوب گذاری گرم شد، پیش سازهای گازی برای رسوب به محفظه واکنش وارد می شوند. گازهای واکنش پذیر به سطح ویفر منتشر می شوند و سپس در شرایط دمای بالا تحت واکنش های شیمیایی روی سطح ویفر قرار می گیرند تا رسوبات جامد (لایه های نازک) را تشکیل دهند.
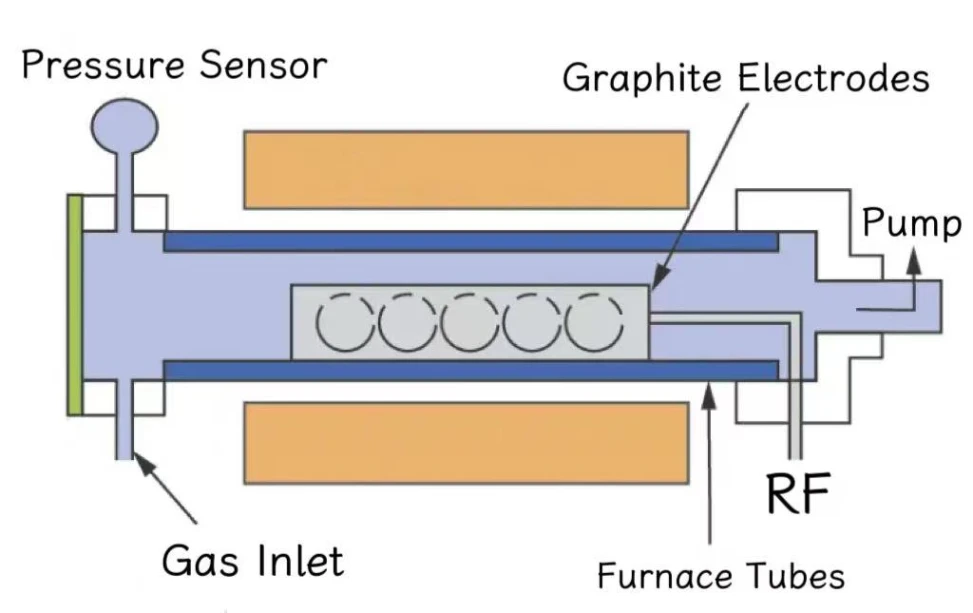
مزایای فرآیندهای LPCVD
1. کیفیت رسوب لایه نازک با کیفیت بالا
سرعت انتقال گازهای واکنش دهنده هنگامی که فشار کم است، تسریع می شود زیرا ضریب انتشار گازها افزایش می یابد. بنابراین، توزیع یکنواخت تری از مولکول های گاز را می توان در سراسر محفظه واکنش ایجاد کرد، که تضمین می کند که مولکول های گاز به طور کامل با سطح ویفر واکنش می دهند و به طور قابل توجهی فضاهای خالی یا اختلاف ضخامت ناشی از واکنش های ناقص را کاهش می دهد.
2. پوشش این مرحله فیلم عالی است
افزایش قابلیت انتشار گاز تحت فشار کم به آن اجازه می دهد تا به عمق ساختارهای پیچیده نفوذ کند. این تضمین می کند که گاز راکتیو در تماس کامل با پله ها و ترانشه های روی سطح ویفر قرار می گیرد و به رسوب یکنواخت لایه های نازک می رسد. در نتیجه، رسوب لایه نازک بر روی ساختارهای پیچیده کاربرد خوبی برای روش LPCVD است.
3.قابلیت کنترل عملیاتی قوی
فرآیندهای LPCVD در طول عملیات واقعی کنترل پذیری قوی از خود نشان می دهند. ترکیب، ساختار و ضخامت لایه نازک را می توان با تنظیم پارامترهای گاز واکنش دهنده مانند نوع، سرعت جریان، دما و فشار به طور دقیق کنترل کرد. تجهیزات LPCVD در مقایسه با سایر فناوریهای رسوبگذاری هزینههای سرمایهگذاری و عملیاتی نسبتاً کمی دارند و آن را برای تولید صنعتی در مقیاس بزرگ مناسب میسازند. و سازگاری در فرآیندها در طول تولید انبوه را می توان به طور موثر با سیستم های خودکاری که در زمان واقعی نظارت و تنظیم می کنند تضمین کرد.
معایب فرآیندهای LPCVD
از آنجایی که فرآیندهای LPCVD معمولاً در دماهای بالا انجام میشوند، که کاربرد برخی از مواد حساس به دما را محدود میکند، ویفرهایی که باید توسط LPCVD پردازش شوند باید در برابر حرارت مقاوم باشند. در طول فرآیندهای LPCVD، مسائل ناخواسته ممکن است ایجاد شود، مانند رسوب دهی به دور ویفر (لایه های نازکی که در نواحی غیر هدف ویفر رسوب می کنند) و مشکلات دوپینگ درجا، که برای حل آنها نیاز به پردازش بعدی دارد. علاوه بر این، غلظت کم پیش سازهای بخار در شرایط فشار کم ممکن است منجر به نرخ رسوب لایه نازک پایین تر شود و در نتیجه منجر به راندمان تولید ناکارآمد شود.
Semicorex کیفیت بالایی را ارائه می دهدSiC fلوله urnaces, SiC پاروهای کنسولیوقایق های ویفر SiCبرای فرآیندهای LPCVD. اگر سؤالی دارید یا نیاز به جزئیات بیشتری دارید، لطفاً در تماس با ما دریغ نکنید.
تلفن تماس 86-13567891907
ایمیل: sales@semicorex.com





