
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in Chip Manufacturing: A Professional News Report
تکامل مواد نیمه هادی
در حوزه فناوری نیمه هادی مدرن، حرکت بی امان به سمت کوچک سازی، محدودیت های مواد سنتی مبتنی بر سیلیکون را تحت فشار قرار داده است. SiGe (سیلیکون ژرمانیوم) برای پاسخگویی به نیازهای عملکرد بالا و مصرف انرژی کم، به دلیل خواص فیزیکی و الکتریکی منحصر به فرد خود، به عنوان یک ماده مرکب انتخابی در تولید تراشه های نیمه هادی ظاهر شده است. این مقاله به این موضوع می پردازدفرآیند اپیتاکسیSiGe و نقش آن در رشد اپیتاکسیال، کاربردهای سیلیکون فشرده، و ساختارهای Gate-All-Around (GAA).
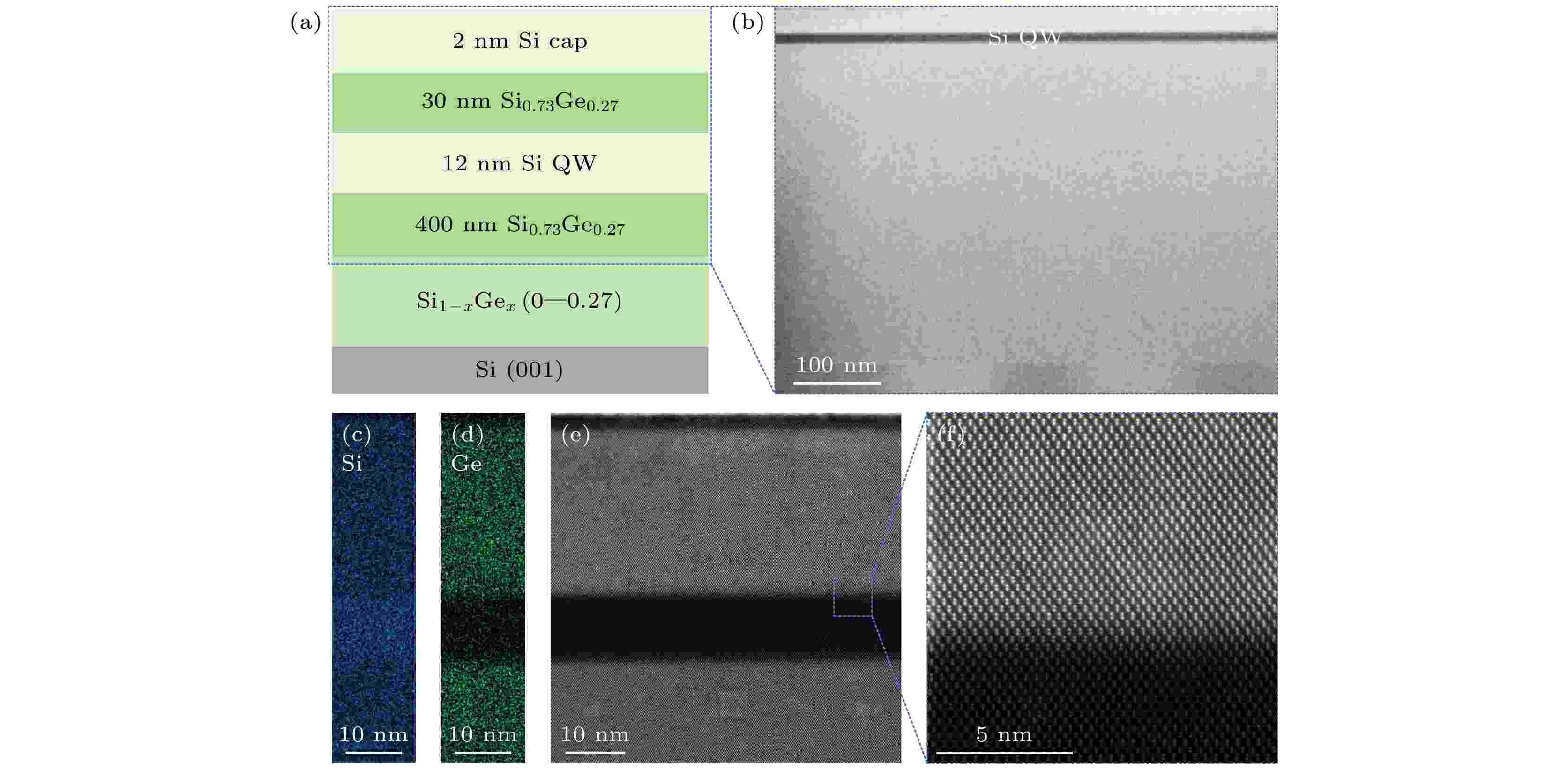
اهمیت اپیتاکسی SiGe
1.1 مقدمه ای بر اپیتاکسی در ساخت تراشه:
اپیتاکسی که اغلب با نام Epi به اختصار خوانده می شود، به رشد یک لایه تک بلوری بر روی یک بستر تک بلوری با آرایش شبکه ای یکسان اشاره دارد. این لایه می تواند هر دو باشدهومواپیتاکسیال (مانند Si/Si)یا هترواپیتاکسیال (مانند SiGe/Si یا SiC/Si). روشهای مختلفی برای رشد همپایی استفاده میشود، از جمله اپیتاکسی پرتو مولکولی (MBE)، رسوب بخار شیمیایی با خلاء فوقالعاده بالا (UHV/CVD)، اپیتاکسی اتمسفری و فشار کاهشیافته (ATM & RP Epi). این مقاله بر روی فرآیندهای اپیتاکسی سیلیکون (Si) و سیلیکون-ژرمانیوم (SiGe) که به طور گسترده در تولید مدار مجتمع نیمه هادی با سیلیکون به عنوان ماده زیرلایه استفاده می شود، تمرکز دارد.
1.2 مزایای SiGe Epitaxy:
ترکیب نسبت معینی از ژرمانیوم (Ge) در طولفرآیند اپیتاکسییک لایه تک کریستالی SiGe را تشکیل می دهد که نه تنها عرض باند را کاهش می دهد بلکه فرکانس قطع ترانزیستور (fT) را نیز افزایش می دهد. این باعث می شود که به طور گسترده در دستگاه های فرکانس بالا برای ارتباطات بی سیم و نوری قابل استفاده باشد. علاوه بر این، در فرآیندهای مدار مجتمع پیشرفته CMOS، عدم تطابق شبکه (حدود 4 درصد) بین Ge و Si باعث ایجاد تنش شبکه میشود و تحرک الکترونها یا حفرهها را افزایش میدهد و در نتیجه جریان اشباع دستگاه و سرعت پاسخ را افزایش میدهد.
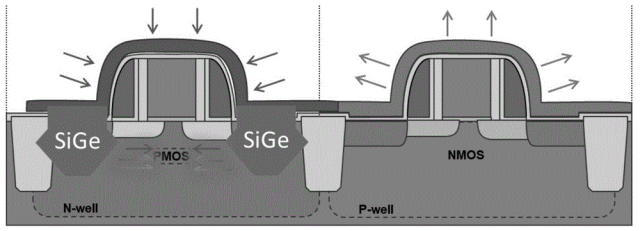
جریان جامع SiGe Epitaxy Process
2.1 قبل از درمان:
ویفرهای سیلیکونی بر اساس نتایج مورد نظر فرآیند، عمدتاً شامل حذف لایه اکسید طبیعی و ناخالصیهای روی سطح ویفر، پیش تصفیه میشوند. برای ویفرهای بستر بسیار دوپ شده، مهم است که در نظر بگیریم که آیا آب بندی پشتی برای کاهش دوپینگ خودکار در طی مراحل بعدی ضروری است یا خیر.رشد اپیتاکسی.
2.2 گازها و شرایط رشد:
گازهای سیلیکونی: سیلان (SiH4)، دی کلروسیلان (DCS، SiH2Cl2) و تری کلروسیلان (TCS، SiHCl3) سه منبع گاز سیلیکونی هستند که بیشترین استفاده را دارند. SiH4 برای فرآیندهای اپیتاکسی کامل در دمای پایین مناسب است، در حالی که TCS که به دلیل سرعت رشد سریع خود شناخته شده است، به طور گسترده برای تهیه مواد ضخیم استفاده می شود.اپیتاکسی سیلیکونیلایه ها
گاز ژرمانیوم: ژرمان (GeH4) منبع اولیه برای افزودن ژرمانیوم است که همراه با منابع سیلیکونی برای تشکیل آلیاژهای SiGe استفاده می شود.
اپیتاکسی انتخابی: رشد انتخابی با تنظیم نرخ های نسبی حاصل می شودرسوب اپیتاکسیالو اچ در محل، با استفاده از گاز سیلیکون حاوی کلر DCS. انتخاب پذیری به این دلیل است که جذب اتم های کلر روی سطح سیلیکون کمتر از اکسیدها یا نیتریدها است که رشد اپیتاکسی را تسهیل می کند. SiH4، فاقد اتم های کلر و با انرژی فعال سازی کم، به طور کلی فقط برای فرآیندهای اپیتاکسی کامل در دمای پایین اعمال می شود. یکی دیگر از منابع متداول سیلیکونی، TCS، فشار بخار پایینی دارد و در دمای اتاق مایع است و برای وارد کردن آن به محفظه واکنش، نیاز به حباب H2 دارد. با این حال، نسبتاً ارزان است و اغلب برای سرعت رشد سریع آن (تا 5 میکرومتر در دقیقه) برای رشد لایههای اپیتاکسی سیلیکونی ضخیمتر استفاده میشود که به طور گسترده در تولید ویفر اپیتاکسی سیلیکونی استفاده میشود.
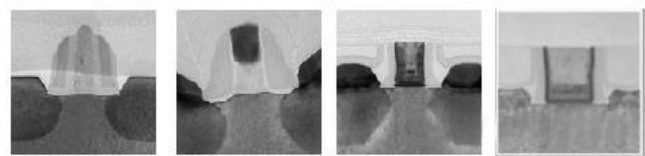
سیلیکون صاف شده در لایه های اپیتاکسیال
در طولرشد اپیتاکسیالسی تک کریستالی همپایه روی یک لایه SiGe آرام رسوب میکند. به دلیل عدم تطابق شبکه بین Si و SiGe، لایه تک کریستالی Si تحت تنش کششی از لایه SiGe زیرین قرار میگیرد و به طور قابل توجهی تحرک الکترون را در ترانزیستورهای NMOS افزایش میدهد. این فناوری نه تنها جریان اشباع (Idsat) را افزایش می دهد، بلکه سرعت پاسخ دستگاه را نیز بهبود می بخشد. برای دستگاههای PMOS، لایههای SiGe پس از اچ کردن، بهصورت همبستگی در مناطق منبع و تخلیه رشد میکنند تا تنش فشاری روی کانال ایجاد شود، تحرک سوراخها و جریان اشباع افزایش یابد.
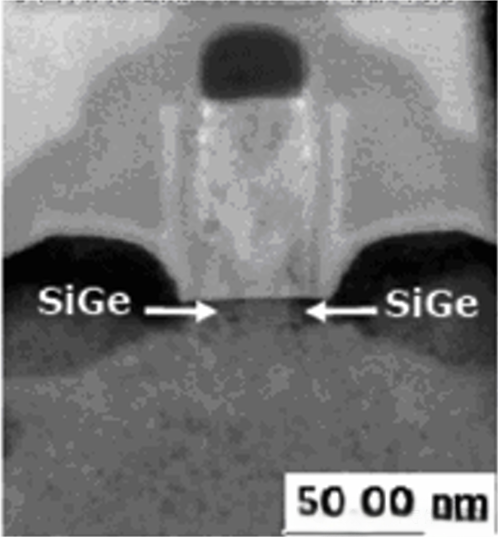
SiGe به عنوان یک لایه قربانی در ساختارهای GAA
در ساخت ترانزیستورهای نانوسیمی Gate-All-Around (GAA)، لایه های SiGe به عنوان لایه های قربانی عمل می کنند. تکنیکهای اچینگ ناهمسانگرد با گزینش بالا، مانند اچینگ لایه شبه اتمی (شبه ALE)، امکان حذف دقیق لایههای SiGe را برای تشکیل ساختارهای نانوسیم یا نانوصفحه فراهم میکند.
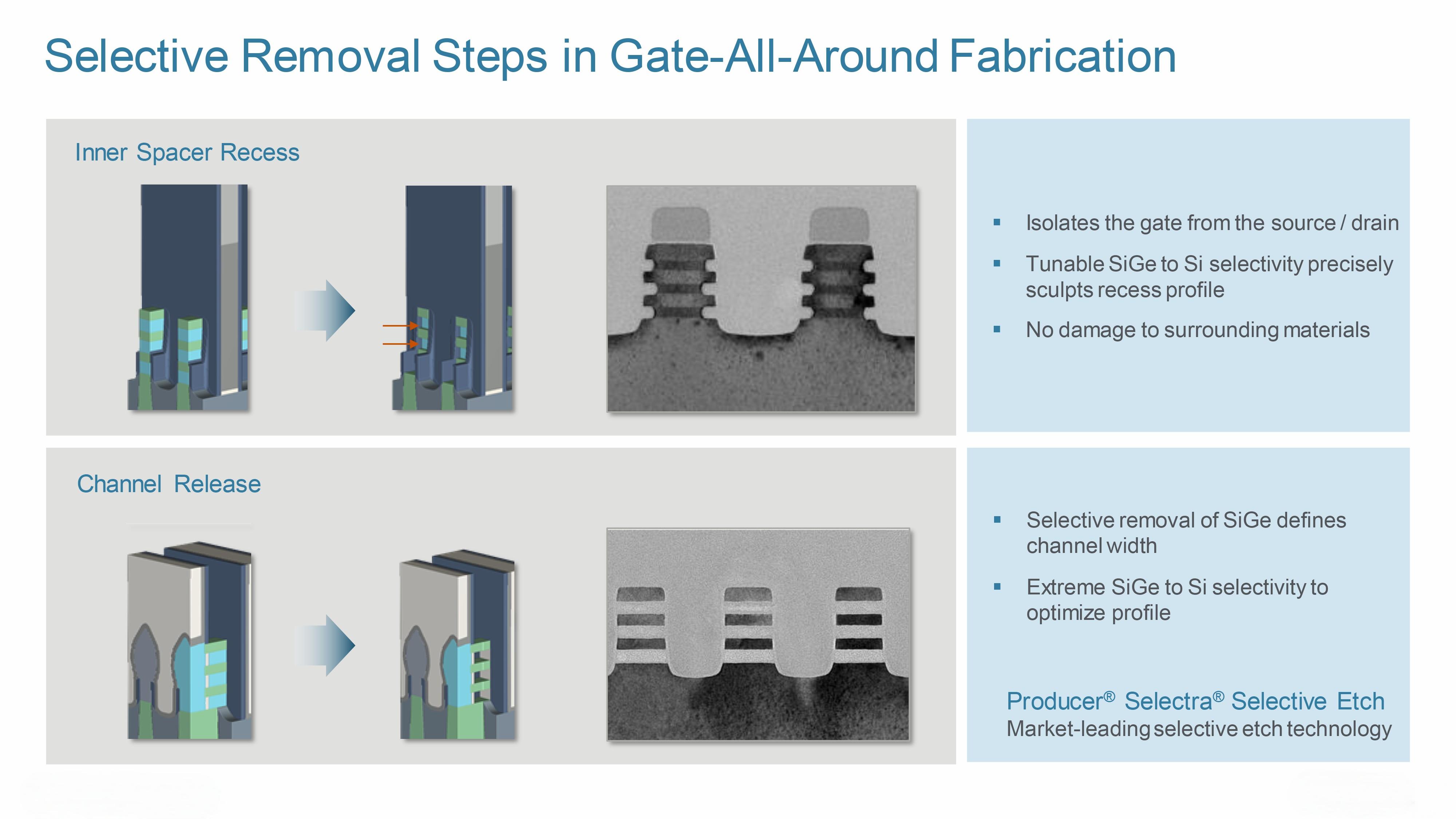
ما در Semicorex در این زمینه تخصص داریممحلول های گرافیتی با پوشش SiC/TaCدر رشد همپایه Si در تولید نیمه هادی استفاده می شود، اگر سؤالی دارید یا به جزئیات بیشتری نیاز دارید، لطفاً در تماس با ما دریغ نکنید.
تلفن تماس: +86-13567891907
ایمیل: sales@semicorex.com




