
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
فناوری اچینگ انتخابی SiGe و Si
Gate-All-Around FET (GAAFET)، به عنوان یک معماری ترانزیستوری نسل بعدی که آماده جایگزینی FinFET است، به دلیل توانایی خود در ارائه کنترل الکترواستاتیک برتر و عملکرد بهبود یافته در ابعاد کوچکتر توجه قابل توجهی را به خود جلب کرده است. یک مرحله مهم در ساخت GAAFET های نوع n شامل گزینش پذیری بالا استحکاکی کردنپشتههای SiGe:Si قبل از رسوب اسپیسرهای داخلی، تولید نانوصفحات سیلیکونی و کانالهای آزاد.

این مقاله به بحث انتخابی می پردازدفن آوری های حکاکیدر این فرآیند شرکت کرده و دو روش جدید اچ را معرفی می کند - اچینگ بدون پلاسما با گاز اکسیداتیو بالا و اچینگ لایه اتمی (ALE) - که راه حل های جدیدی را برای دستیابی به دقت و انتخاب پذیری بالا در اچ SiGe ارائه می دهد.
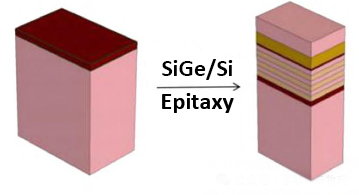
لایه های سوپرشبکه SiGe در سازه های GAA
در طراحی GAAFET ها برای افزایش عملکرد دستگاه، لایه های متناوب Si و SiGe هستندبه صورت اپیتاکسیال روی یک بستر سیلیکونی رشد می کند، ساختاری چند لایه را تشکیل می دهد که به عنوان ابرشبکه شناخته می شود. این لایههای SiGe نه تنها غلظت حامل را تنظیم میکنند، بلکه با وارد کردن تنش، تحرک الکترونها را بهبود میبخشند. با این حال، در مراحل بعدی فرآیند، این لایههای SiGe باید با حفظ لایههای سیلیکونی دقیقاً حذف شوند، که به فناوریهای اچینگ بسیار انتخابی نیاز دارد.
روشهای اچینگ انتخابی SiGe
اچینگ بدون پلاسما با گاز اکسیداتیو بالا
انتخاب گاز ClF3: در این روش اچ از گازهای بسیار اکسیداتیو با گزینش پذیری فوق العاده مانند ClF3 استفاده می شود که به نسبت گزینش SiGe:Si 1000-5000 دست می یابد. می توان آن را در دمای اتاق بدون آسیب رساندن به پلاسما تکمیل کرد.
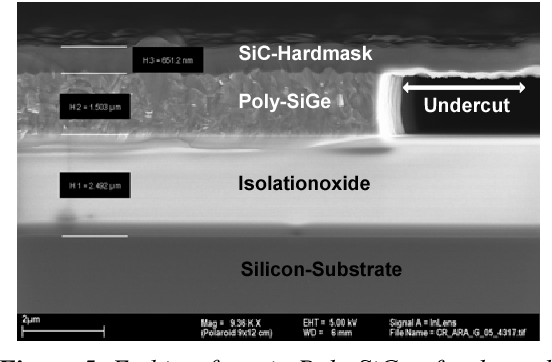
راندمان دمای پایین: دمای مطلوب حدود 30 درجه سانتیگراد است، حکاکی با انتخاب پذیری بالا در شرایط دمای پایین، اجتناب از افزایش بودجه حرارتی اضافی، که برای حفظ عملکرد دستگاه بسیار مهم است.
محیط خشک: کلفرآیند اچینگتحت شرایط کاملا خشک انجام می شود و خطر چسبندگی ساختار را از بین می برد.
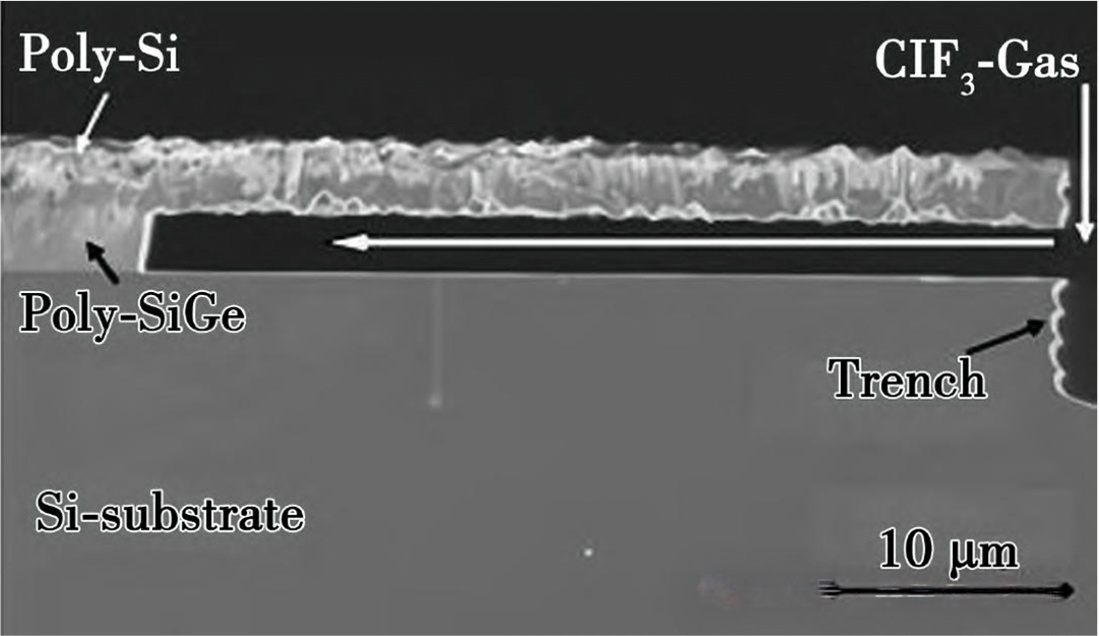
اچینگ لایه اتمی (ALE)
ویژگی های خود محدود شونده: ALE یک چرخه دو مرحله ای استتکنولوژی اچینگ، که در آن ابتدا سطح ماده ای که باید اچ شود اصلاح می شود و سپس لایه اصلاح شده بدون تأثیر بر روی قسمت های اصلاح نشده حذف می شود. هر مرحله به خودی خود محدود می شود و دقت را تا سطح حذف چند لایه اتمی در یک زمان تضمین می کند.
حکاکی چرخه ای: دو مرحله فوق به طور مکرر چرخه می شوند تا عمق اچ مورد نظر به دست آید. این فرآیند ALE را قادر می سازد تا به آن دست یابدحکاکی دقیق در سطح اتمیدر حفره های کوچک روی دیواره های داخلی.

ما در Semicorex در این زمینه تخصص داریممحلول های گرافیتی با پوشش SiC/TaCدر فرآیندهای اچینگ در تولید نیمه هادی اعمال می شود، اگر سؤالی دارید یا به جزئیات بیشتری نیاز دارید، لطفاً در تماس با ما دریغ نکنید.
تلفن تماس: +86-13567891907
ایمیل: sales@semicorex.com




